AIの活用によりデバイス微細化に伴う課題を解決し、お客さまの生産性向上と品質管理に貢献
2024年2月26日
株式会社日立製作所
日立は、半導体デバイスの製造工程で発生する微小な欠陥の検出精度向上をめざし、AIを活用した画像解析技術を開発しました。SEM*1式の半導体欠陥検査装置では、デバイス表面に電子線を走査しながら二次電子*2や反射電子*3などを検出し、表面の形態や欠陥を画像として観察します。近年のデバイスの微細化に伴う検査点の増加に対し、電子線をデバイスの広範囲に走査して検査すると、複数回の電子線照射で試料状態が変化して検出される電子の量が不均一となり、画像の輝度値の分布が観察場所ごとに変動し、従来の検査手法*4では精度が低下する課題が生じていました。
今回、日立は、長年にわたる電子顕微鏡の技術と、幅広い事業領域で開発されたデジタル技術を融合し、AIを活用して観察場所ごとの輝度値の分布を推定する技術を開発しました(図1)。検出精度が低い条件*5における検査データに本技術を適用した結果、検査精度が約10倍向上することを確認しました。広範囲の欠陥検査における欠陥検出の精度を改善することが可能になり、半導体デバイスを製造するお客さまの生産性向上と品質管理に寄与することをめざします。
なお、本成果は2024年2月25日~29日に開催されるSPIE Advanced Lithography + Patterning 2024で発表予定です。
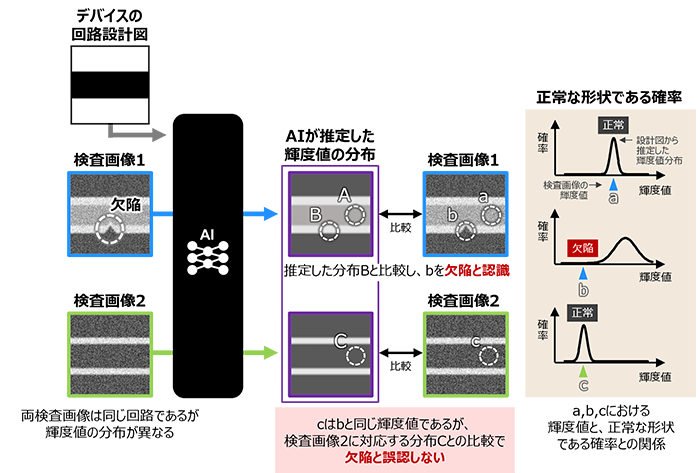
図1 AIを活用して観察場所ごとの輝度値の分布を推定する技術
(デバイスの回路設計図と検査画像をAIが解析し、観察場所(検査画像1、検査画像2)ごとに輝度値の分布を推定することで、欠陥(b)の存在を正しく認識。cの場所はbと同じ輝度であるが、輝度値の分布が異なることが推定されているため欠陥と誤認しない。)